-
ラピスの特徴
-
MEMS技術
-
保有設備・工程
MEMSファウンドリの特徴
量産実績
豊富なアプリケーションの開発・量産実績
○加速度センサ、圧力センサ、IRセンサの量産実績
○ピエゾMEMSファウンドリの量産実績
○MEMS・センサ・ピエゾ素子の開発~量産までスピーディに対応
ラピスのWP 、MEMSエンジニアが共同で開発いたします

MEMS技術
6Φ半導体ライン+MEMS専用ライン
○半導体プロセス・設備を使用 ~0.25um line & space、多層配線、CMP等
○豊富なMEMS技術と専用設備の保有
○表面加工、裏面加工、ウエハ接合、陽極接合、真空封止
高性能なゾルゲル方式PZT形成
MEMS技術のご紹介
①Si深堀エッチングによる、貫通孔・表面加工
a) DRYエッチング
エッチング&デポのサイクルを繰り返すことで、側壁を保護しつつ垂直な穴を開孔します。
開孔が深くなっても垂直を維持し、ウエハを貫通することもできます。
また適切な条件を設定することにより穴を「広げる・すぼめる」を自在に実現します。
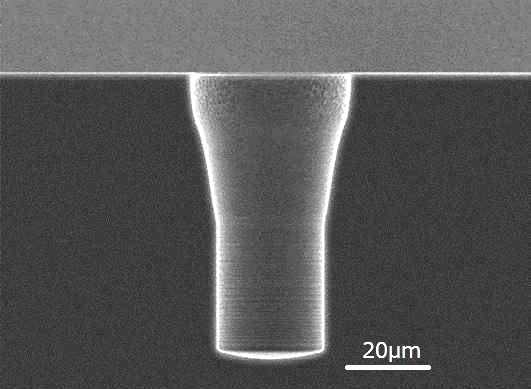
b) 異方性Wetエッチング(アルカリエッチング)
アルカリ溶液(TMAH)が、Siを[111]方位に沿ってエッチングする特性を利用して異方性選択エッチングを行います。高いエッチングレート、多数のウエハを同時にエッチング処理が可能。生産性が優れ、低コストで処理ができる手法です。

②ウエハ接合/ウエハを積層して3D構造をつくる
a) 樹脂接合
接着剤や感光性ポリイミドを塗布。位置合わせ後、高温高圧を加えて貼り合せます。表面に凹凸があっても極薄1umの樹脂をバッファとして接合し、立体的な3D構造を創る事ができます。

b) ガラス陽極接合
ガラスウエハ (SiO2) と シリコンウエハ (Si) を共有接合します。
真空中でガラスの温度を上げて軟化させ、高電圧を印加して静電気力により接合します。センサ内部の真空を保持したり、実装時に裏面加工面を保護する等に利用します。

③PZT技術/ゾルゲル方式によるトップレベルの高性能PZT
スピンコート法によるゾルゲル厚膜PZTを形成します。下部電極の膜質を制御し高い配向性のPZT膜を均一に形成します。
・逆圧電定数 -260【pm/V】
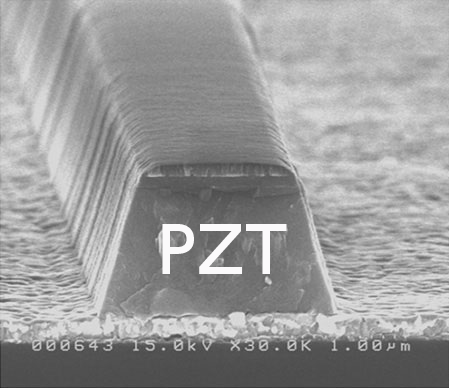
④Flip Chip ボンディング/ウエハ上に他のICチップをAuバンプ接続
制御ICをMEMSチップ上に実装。
IC占有面積の縮小、ノイズの低減などに効果を発揮します。
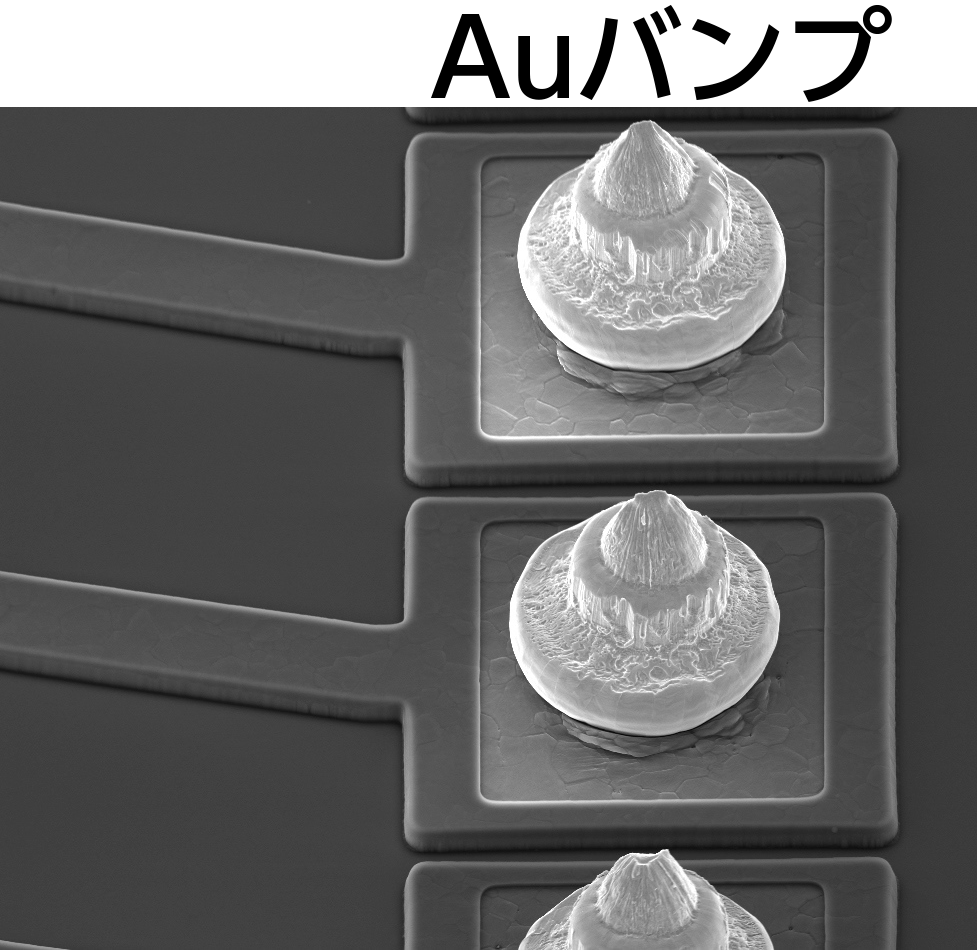
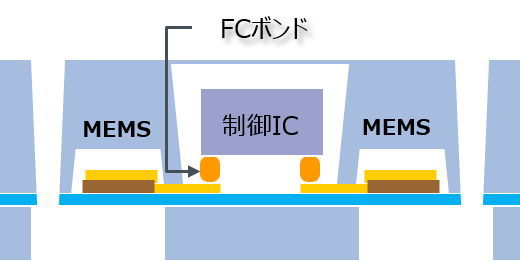
⑤ALD(Atomic Layer Deposition)原子層堆積
原子層レベルをステップで堆積する成膜方法
Al2O3膜等の絶縁保護膜を
・ どのような隙間にも均一に
・ 高カバレッジ(≒100%)
・ 精密膜厚制御
で形成する事ができます。
親水膜・撥水膜も形成できます。
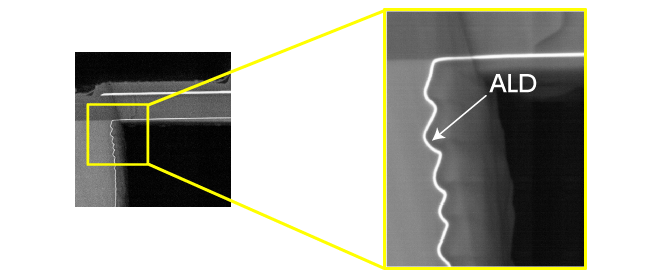
⑥真空パッケージ/ セラミックパッケージ内を真空に保持
IRセンサ、モーションセンサ、RFスイッチに使える真空PKG
・ 高真空求められる製品では、ゲッターを内封
・ IR透過性が必要な製品では、SiやGe等のリッドを使用可
・ 真空中でAuSn やハンダで封止

LSI・MEMS工程で使用可能な設備と工程
| プロセス分類 | 設備 |
| フォトリソ | レジスト塗布・現像 |
| アライナー、両面アライナ | |
| i線ステッパ、IRステッパー | |
| 成膜 | Sol-gel (PZT) |
| PE-CVD(SiO2, SiN) | |
| AP-CVD(SiO2, doped SiO2) | |
| LP-CVD (SiO2, Si2N3, poly-Si) | |
| Metal-CVD(W) | |
| 熱酸化炉、アニール炉 | |
| スパッタ(Al合金, Au, Ti, TiN, TiW, Pt, Ir) | |
| ALD (Al2O3, SiO2, Ta2O5) | |
| Dope | イオンインプラ(B, P, As, Ar, Si) |
| 平坦化・研削 | CMP、バックグラインド、バックエッチング |
| ラミネート | UVテープ、熱剥離テープ、ポリイミド等 |
| ドライエッチング | Si深堀エッチング |
| 層間膜RIE装置 | |
| メタルエッチャー | |
| PZT・電極用ICPエッチャ | |
| ウェットエッチング | シリコン酸化膜エッチング |
| Auエッチング | |
| Si異方性エッチング(TMAH) | |
| 剥離・洗浄 | アッシャー、有機・ポリマー剥離 |
| RCA洗浄、酸洗浄 | |
| ウエハスクラバ | |
| ウェハ接合 | 樹脂接合、陽極接合 |
| 個片化等 | ダイシング、2流体洗浄 |
| サークルカットダイサー | |
| アセンブリ | 真空封止、FCボンディング |
LSI・MEMS工程で使用可能な設備と工程のご紹介(2)
| プロセス分類 | 設備 |
| 計測関係 | 測長SEM |
| 光学式測長装置 | |
| 表裏ずれ測定装置 | |
| 可視光・IR・レーザー顕微鏡 | |
| X線回折装置、蛍光X線分析装置 | |
| レーザー式変位測定装置 | |
| 接針式段差計、光学式干渉段差計 | |
| エリプソメータ、膜厚計、シート抵抗測定 | |
| 自動外観検査装置 | |
| Trパラメータ測定、テスター、真空プローバ | |
| 解析関係 | 断面SEM・SEM-EDX |
| FIB・断面TEM | |
| TDS分析 | |
| 各種顕微鏡 | |
| マニュアルプローバー・テスター | |
| パラメーター測定装置 | |
| 接触角測定 | |
| イオンミーリング | |
| 信頼性試験(高温・高湿・温度サイクル) | |
| EM試験 |